アルバック( http://www.ulvac.co.jp/ )は、次世代のMEMSデバイスで主流となるCMOS搭載MEMSデバイス向けに量産用低温PZTスパッタリング技術を開発したと発表した。
スマートフォンやタブレットPC、自動車などには、加速度センサやジャイロセンサ、さらに圧力センサなどが使用されている。近年、これら機能の根幹となる圧電材料として、PZT(チタン酸ジルコン酸鉛、Pb(Zr,Ti)O3)の薄膜を用いた圧電MEMS (Micro Electro Mechanical Systems)デバイスの需要が高まっている。さらに次世代技術として、圧電MEMSを半導体先進デバイスのCMOS(Complementary Metal Oxide Semiconductor)と融合することでデバイスの高性能化・多機能化・小型化を図り、応用範囲の飛躍的拡大を目指した動きが加速している。
実用化で最も有力とされているPZT圧電MEMSの場合、一般的にPZT薄膜の結晶化温度はスパッタリング法で600℃程度、ゾルゲル法で700℃程度と高温プロセスが必要なため、500℃以下の低温プロセスが必要なCMOSへの搭載が困難だった。同社は、独自技術によりCMOSへ搭載可能な圧電MEMSデバイス用PZT薄膜を500℃以下のスパッタリングプロセスにより形成し、最高レベルの圧電性能と素子の信頼性に必要な高絶縁耐圧、耐疲労性能を満たす技術を世界で初めて実現することができたという。
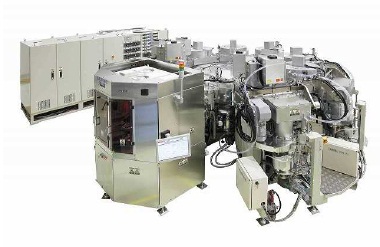 アルバックが開発したスパッタリング装置 PZT薄膜を用いた圧電素子はシリコン基板上に密着層、下部電極層、バッファ層、圧電層(PZT)、上部電極層と大きく分けて五つの層で形成される。同社が開発した枚葉式スパッタリング装置は、これらすべての積層構造が一貫して形成可能。一貫成膜することで、各積層膜に対して最適化されたプロセス室で連続的な処理を行うことができ、再現性の高い積層プロセスの実現と、スループットの改善が可能。この装置はMEMSデバイス製造ラインでは大型基板にあたるφ8インチシリコン基板へ高均一で安定的に素子形成することを技術開発の前提としている。よってDCおよびRFマグネトロンスパッタリング室、結晶化促進のためのRTA(Rapid Thermal Annealing)室等、最大7室のプロセス室と、ロードロック室(仕込/取出室)の搭載が可能となりる。
アルバックが開発したスパッタリング装置 PZT薄膜を用いた圧電素子はシリコン基板上に密着層、下部電極層、バッファ層、圧電層(PZT)、上部電極層と大きく分けて五つの層で形成される。同社が開発した枚葉式スパッタリング装置は、これらすべての積層構造が一貫して形成可能。一貫成膜することで、各積層膜に対して最適化されたプロセス室で連続的な処理を行うことができ、再現性の高い積層プロセスの実現と、スループットの改善が可能。この装置はMEMSデバイス製造ラインでは大型基板にあたるφ8インチシリコン基板へ高均一で安定的に素子形成することを技術開発の前提としている。よってDCおよびRFマグネトロンスパッタリング室、結晶化促進のためのRTA(Rapid Thermal Annealing)室等、最大7室のプロセス室と、ロードロック室(仕込/取出室)の搭載が可能となりる。
同装置では、高揮発性材料の鉛を含むPZT特有の鉛組成制御と安定成膜技術を実現した誘電体専用スパッタリングチャンバを採用し、加熱した基板上にPZT薄膜を結晶成長させながら堆積させることができる。また、PZT薄膜の低温プロセスの実現には同社独自のプロセス技術としてバッファ層をはじめとする新技術を採用し、500℃以下の低温プロセスでありながら、PZT薄膜の膜厚2.0μmにおける電気特性は圧電定数(e31) :-17C/m2、絶縁耐圧: ±100V、サイクル特性: >1011回であり、PZT薄膜において世界最高レベルの性能を量産条件で確認しているという。






