電力中央研究所(電中研)、デンソー、昭和電工は共同で、新しい低損失パワー半導体用の素材であるSiC単結晶膜の高品質・高速製造技術を確立した。今後、高品質SiC単結晶膜の製造に同技術を用いていくとともに、ハイブリット車(HV)などのモーター駆動力を制御するパワーコントロールユニット(PCU)や、電力系統における周波数変換などの電力制御機器への適用を目指す。
最近、一部の家電機器、産業機器、鉄道において、SiCパワー半導体の実用化がされているが、HVや、電力系統への適用に向けては、高品質なSiC単結晶膜を高速に製造する生産技術が確立されていなかった。この課題の解決に向けて、電中研とデンソーは、2009年から高品質SiC単結晶膜の高速製造技術の開発に共同で取り組み、ニューフレアテクノロジーと共同で新型の枚葉式SiC単結晶膜製造装置を開発するとともに、2013年までに同装置を用いた大口径・高速SiC単結晶膜製造の基礎技術を確立した。2013年からは、昭和電工が共同開発に参加し、高品質SiC単結晶膜の高速製造技術の開発を進めてきた。
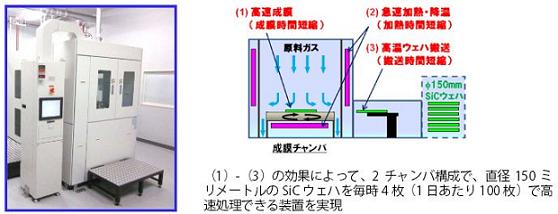
今回3社は、直径150mm、膜厚均一性2%以下、ドーピング(不純物)密度均一性4%以下(標準偏差を平均値で割った値、膜厚は外周3mm、ドーピング密度は外周6mmを除く)と従来比約3倍優れた均一性を有する高品質SiC単結晶膜を1時間あたり50μm以上と従来比5~10倍の高い成膜速度で製造できる技術の開発に成功した。

SiC単結晶膜の製造過程で生成される欠陥密度は、光学式表面検査装置による欠陥検査で1cm四方あたり0.02個(直径150mm単結晶膜中のダウンフォール、立方晶欠陥の合計値)と従来比1/5以下、発光解析による欠陥検査で1cm四方あたり0.05個(高品位基板上の直径75mm単結晶膜中の各種積層欠陥の合計値)であることを確認した。
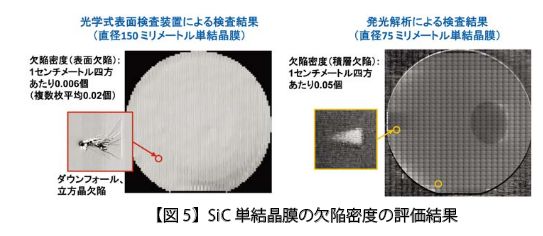
これにより、膜厚10μm換算で、1装置で1日あたり100枚の直径150mm高品質SiC単結晶膜の製造が可能となった。また、製造装置内の消耗部品の高耐久化や、メンテナンス頻度の低減など、量産化、低コスト化のための技術も高めた。今後、高品質SiC単結晶膜の製造に本技術を適用していく計画。






