 日立ハイテクノロジーズ( http://www.hitachi-hightech.com/jp )は、三次元構造解析の精度・スループットを向上した、リアルタイム3DアナリティカルFIB(Focused Ion Beam:集束イオンビーム加工装置)-SEM(Scanning Electron Microscope:走査電子顕微鏡)複合装置 「NX9000」の販売を開始した。
日立ハイテクノロジーズ( http://www.hitachi-hightech.com/jp )は、三次元構造解析の精度・スループットを向上した、リアルタイム3DアナリティカルFIB(Focused Ion Beam:集束イオンビーム加工装置)-SEM(Scanning Electron Microscope:走査電子顕微鏡)複合装置 「NX9000」の販売を開始した。
光学顕微鏡やSEMを用いた表面形状の観察は、先端材料や半導体デバイスから医学・生物までの幅広い分野で行われているが、試料本来の構造をより正しく理解する上で、内部構造の解析がますます重要になっている。そのため、特定位置での断面作製や超薄膜作製が可能なFIBは、断面のSEM観察やTEM(Transmission Electron Microscope:透過電子顕微鏡)解析に欠かせないツールとして、その利用が広がっている。
一方、FIBとSEMの複合装置による三次元構造解析にも、近年、大きな注目が集まっている。FIBによる断面作製とSEM観察を自動で繰り返すことで、連続断面シリーズ像を収集し、特定微小部の三次元構造を解析することができる。
同品は、通常斜めに配置されるSEMカラムとFIBカラムを直角に配置することで、三次元構造解析に最適なレイアウトを実現した。これにより、従来のFIB-SEM複合装置の課題であった、断面SEM像の縮みや連続画像収集時の視野ズレを回避し、試料本来の構造に忠実な画像を安定して取得することができる。また、顧客に定評のある高輝度冷陰極電界放出形電子銃と高感度検出系により、生物組織から鉄鋼などの磁性材料まで、多様な試料の高コントラスト・高分解能観察に対応している。さらに、EDS(Energy Dispersive x-ray Spectrometer:エネルギー分散型X線分析装置)やEBSD(Electron BackScatter Diffraction:電子線後方散乱回折分析装置)を組み合わせることで、元素や結晶方位の三次元分布の評価も可能となる。
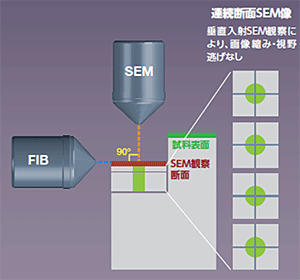 直交型FIB-SEM
直交型FIB-SEM






