日立化成工業( http://www.hitachi-chem.co.jp )は、半導体パッケージ基板と半導体チップの接続方法である銅ワイヤボンディングの信頼性に優れ、かつ半導体パッケージ基板の高密度化に有利な無電解Ni/Pd/Au(ニッケル/パラジウム/金)めっき技術を確立した。
半導体パッケージは、携帯機器を中心に軽量化、薄型化および小型化が進んでいることから、高密度実装が可能なエリアアレイ型表面実装方式のBGA、CSPタイプが増加傾向にあり、これらのパッケージ内部で半導体パッケージ基板と半導体チップを接続する方法については、蓄積技術の豊富さや実績からワイヤボンディングタイプが主流となっている。
ワイヤボンディングは、電気抵抗が低く、加工性が良好で接続信頼性の高い金ワイヤが用いられてきたが、近年の金の価格高騰により、安価な銅ワイヤへの置換が普及しつつあり、特に中国、台湾地域において急速に広まっている。銅ワイヤを使用する際、半導体パッケージ基板端子側の接続には従来の金ワイヤ用の電解Ni/Au(ニッケル/金)めっきを流用していたが、半導体パッケージ基板の高密度化に限界があることや、さらなる低コストへの要求といった課題があったという。
同社は、1995年に無電解Ni/Pd/Auめっき技術の開発に成功し、その後、同技術が半導体パッケージ基板の高密度化に有利であり、かつ電解Ni/Auめっき技術と同等レベル以上の金ワイヤボンディングの信頼性があることを解明してきた。そしてこのたび、半導体パッケージ基板用の銅ワイヤボンディング端子で金めっきの種類とワイヤボンディング性との関係を研究した結果、従来の電解Ni/Au(Au:0.3 マイクロメートル)めっきと比較して、無電解Ni/Pd/Au(Au:0.1マイクロメートル)めっきが、パラジウムによるニッケル拡散抑制と金結晶粗大化の相乗効果により、金の厚みを3分の1に低減しても良好な銅ワイヤボンディング性を維持できることを解明し、省資源化、低コスト化に繋がる技術を確立した。今後は銅ワイヤボンディングを採用する顧客向けに、無電解Ni/Pd/Auめっき技術を用いた半導体パッケージ基板や無電解金めっき関連薬品を提供していく。
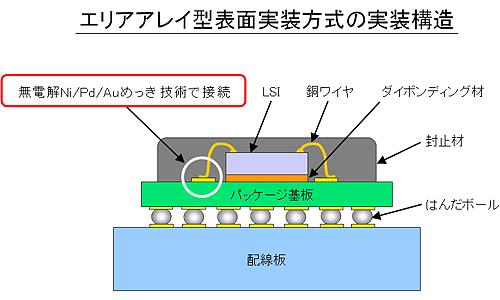 エリアアレイ型表面実装方式の実装構造
エリアアレイ型表面実装方式の実装構造






